技术
材料的位错分析可以提供大量关于变形和应变表征的有用信息。由于原子列的偏移,晶格中的每个位错都会引起微小的取向变化。尽管单个位错引起的取向差很小,无法使用EBSD准确测量,但是很多同种位错聚集引起的取向变化(晶格弯曲)却可以通过EBSD测量。下图展示了同种符号的位错如何引起晶格扭曲,而不同符号的混合位错可能并不会引起宏观的晶格扭曲。

位错和晶格弯曲的示意图:(左)同符号的位错累积造成明显的晶格弯曲(如塑性变形);(右)不同符号的位错相互抵消,并未造成明显的晶格弯曲。
所有的材料都含有不同类型的位错,某些情况下被称为“随机存储位错(SSD)”。那些具有相同符号的位错会造成晶格产生净弯曲,被称为“几何必需位错(GND)”,在大多数情况下,我们可以使用EBSD技术测量GND。
事实上,可以使用EBSD技术测量GND引起的晶格扭曲,这意味着可以使用EBSD导出GND的密度和类型等重要信息。近年来,有许多研究论文涉及这一课题。
位错表征的理论基础是Nye在一次会议论文中首次提出的(J.F. Nye, Some geometrical relations in dislocated crystals, Acta Mater. 1 (1953) 153–162)。在这篇论文里,作者讨论了晶格扭曲和位错密度之间的关系。后来的许多论文也提出了,基于EBSD采集的取向数据,不同的计算位错密度的方法,如下列论文:
在AZtecCrystal中,“位错分析”是一个选配的高级功能模块,它采用加权柏氏矢量(WBV,Weighted Burgers Vector)技术对位错做高级分析。这一技术基于Wheeler等人在下列论文中的工作:
这一方法的原理同样基于Nye(1953)的工作,加权柏氏矢量定义如下:
W = 对所有类型位错求和:[露头位错的密度×柏氏矢量]
加权柏氏矢量结果中的“加权”源于EBSD数据的二维属性。相比与采集平面呈低角度相交的位错线,EBSD更容易检测到与采集平面呈高角度相交的位错线。而平行于采集表面的位错线对检出的位错密度没有任何贡献。因此,计算出来的位错密度总是真实的位错密度下限(真实的位错密度总是高于通过二维EBSD测量得到的位错密度)。除了这个小限制意外,加权柏氏矢量法提供了晶体材料中具有重要意义的位错类型和密度,且不需要像其他位错分析方法那样需要大量的假设。
和许多已经使用的其他的计算方法(如KAM面分布图相同的像素阵列法)相同,加权柏氏矢量计算的标准方法是通过“微分”方法:即,先计算每个像素点的取向梯度,然后计算贡献该取向梯度所需的位错密度。而AZtecCrystal使用Wheeler等人提出的“积分回路法”计算位错密度,实际上是在面分布图上绘制一系列的柏式回路。正常情况下,柏式回路是在晶体坐标系中绘制的(例如,通过围绕单一位错的原子位置测量柏式矢量),其实它也适用在样品表面。这是个封闭的环路,沿环路周长上每个取向的微小变化都对总的净柏式矢量有贡献。晶体坐标系和样品坐标系中柏式回路的对比如下图所示:
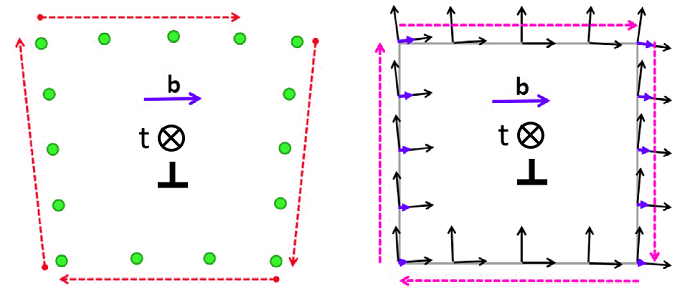
晶体坐标系(左)和样品坐标系(右)中柏式回路的示意图。请注意,两种方法都可以给出相同的柏式矢量(中心紫色箭头,b):在样品坐标系中,柏式环路是闭合的,b就是每步的单个矢量(紫色小箭头)的净总和。而在晶体坐标系中,柏式矢量是回路的未封闭部分。图片修改自论文Konijnenberg et al. (2015)。
在AZtecCrystal中,柏式回路是环绕面分布图中的每个像素点的(用户可定义尺寸和形状),然后计算每个像素点的加权柏式矢量。这种滑动的环状位错分析,对取向测量中的噪声不敏感,因此可以提供更准确的局域柏式矢量的强度和方向。然而,这种滑动完整回路分析法有个缺点:如果环路周长经过另一相或者大角晶界,就不会返回结果。这意味着大角晶界或者相界附近的像素点没有数据。
下图展示了滑动环路WBV法和传统方法得到的位错密度的噪声水平对比效果。GaN薄膜中有许多单根的线位错。采集EBSD数据时使用高精度模式标定,可以获得更高的取向精度,就可以探测到位错引起的细微取向变化(< 0.1°),使用WBV法可以更有效地研究这些位错的本质。与KAM图相比,WBV法得到的位错密度的噪声水平明显降低,位错的分布也更清晰,与相同区域的电子通道衬度像(ECCI)对照可发现,那些线位错都可靠地表征出来了。



含有线位错的GaN薄膜。左:KAM图,用5x5像素阵列的核;中:滑动环路WBV图,用5x5像素环尺寸;右:电子通道衬度图像,显示了单根位错。注意WBV分布图中低噪声水平使单个位错的分析可能。
WBV方法得到的结果有3层含义
上述的三种表现形式可以提供样品中位错的属性和分布的重要信息,帮助研究人员理解材料的变形机制。
在这个案例中,两个钛合金样品在不同的条件下(应变速率、应变量、温度)变形,利用EBSD分析了微观组织和表征变形的机制。
两种样品的GND位错密度分布如下图所示,差异很小。然而,使用GND分布的直方图可以更容易区分两者的差异。
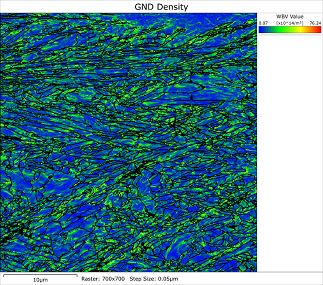
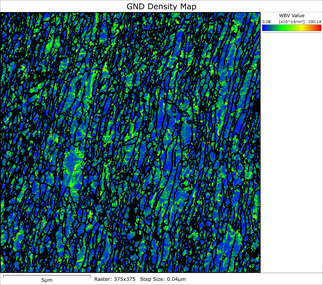
使用WBV法计算的GND密度分布图。左:样品1(加载方向平行于X轴),右:样品2(加载方向平行于Y轴)。注意,样品2的最大GND稍高(样品1:7.6 x 1015 m-2;样品2: 1 x 1016 m-2.)
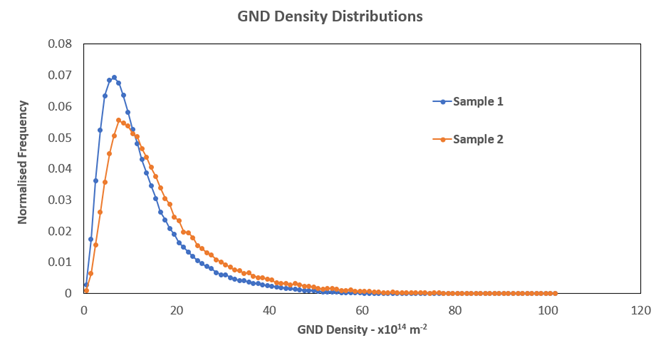
两个钛合金样品的GND密度分布直方图,样品1和样品2的平均GND值分别为1.25 × 1015 m-2、1.62 × 1015 m-2。
两个样品最大的差别在于柏式矢量的方向。对于样品1,WBV方向在基面上有明显的聚集,接近<a>方向,与主导的滑移系<11-20>(0001)一致。相比来说,样品2中WBV的取向在<c>轴方向上有微弱的偏聚,这与非基面滑移的激活相关,如沿<c+a>柏氏矢量的锥面滑移。


样品1(左)和样品2(右)在晶体坐标系中的WBV方向投影反极图,仅显示WBV强度高于最大值15%的WBV的方向。
进一步研究晶界界面、界面的旋转轴和样品的织构,可以帮助研究人员更深入地表征样品中滑移系的本质。从上面结果来看,仅对比两个样品中GND密度,不足以发现两个样品各自变形方式的主要区别,而通过柏氏矢量的方向则可以快速地区分两种不同的滑移机制。
 公安机关备案号31010402003473
公安机关备案号31010402003473